M6米乐手机登录APP入口 新一代的金线替代品-AgCoat® Prime镀金
2024-03-11 08:19:52 1
封装技术总体上可以分为两大类: (1) Wire Bonding 引线) Non-Wire Bonding 非键合工艺,如FC、Clip bond等封装技术。据相关数据统计,使用引线键合这种传统封装工艺的器件仍占据近70%的出货量。虽然近些年来以WLCSP为代表的先进封装技术发展迅速,但传统的封装工艺不会被完全淘汰,两者会长期共存发展。
谈到半导体封装就不得不提到其重要的封装材料—键合线。目前市场上的键合线根据材质分为几大类:金、银、铜、镀钯铜、铝等。这几类线材已得到了广泛应用,这里就不过多赘述,我们就谈谈最新一代的键合线产品—镀金银线
信息:由于黄金具有出色的抗氧化、抗腐蚀能力,及良好的电特性等优点, 被广泛的用于半导体封装中,早期的封装工艺使用的键合线只有金线。但随着黄金价格的不断攀升,在单颗器件中,金线的成本仅次于基板位居第二位(
除外),成为封装厂降低成本的主要目标。此时,铜线、镀钯铜线、银合金线等低成本的材料先后被推向市场,在各自的应用领域占据了一定市场份额。下图为不同键合线的市场用量分析和预测:

、摄像头模组、军工、航空等,这些领域里的产品由于其产品特点决定了不适合使用铜线、银合金线等低成本线材。为何不能用铜线?由于铜线%左右,在一些Pad铝层较薄的产品中,如存储器中Nand Flash有的薄至0.5um,如果打铜线很容易出现Pad Peeling、Crack等问题。相反,有部分产品Pad 铝层较厚,甚至达到4um以上,如果Pad焊点开窗较小,铝层飞溅将是铜线键合的主要挑战。
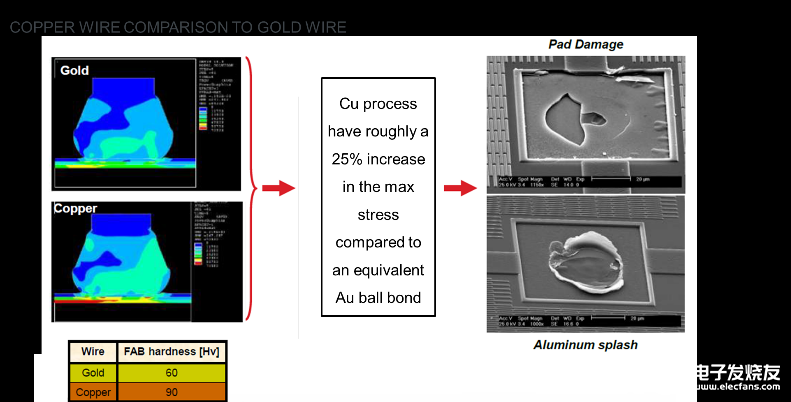
为何不能用银合金线?由于银离子相对比较活跃,尤其在一些高湿的环境中,会产生银离子迁移的情况。同时,在有电流通过的情况下,银离子迁移速率会提高。银离子迁移会导致两个Pad之间短路,最终导致产品失效,尤其是在一些小间距产品上的挑战很大。此外,银容易与硫反应生成硫化银,从而产生可靠性问题。
通常我们在纯银里会参杂一些微量元素以改善上述性能,金(Au)、钯(Pd)常常被选为主要参杂元素。钯会形成氧化钯层从而抑制银离子析出的速度,金会减少自由的银离子的数量从而减少银离子迁移。
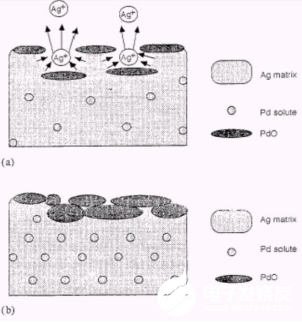
以下是不同纯度的银合金线的银迁移速率的对比。虽然合金会延缓银离子迁移速率,但在一些高湿度的可靠性测试中,银合金线表现出的可靠性还是比金线要差。所以,银合金线通常会在一些低可靠性要求的产品中才有应用。

针对以上铜线、银合金线产品的不足之处,镀金银线被认为是目前这部分金线产品理想的替代品。它具体有哪些优势呢,下面会详细介绍一下。
在介绍产品特性前,先了解一下它的加工过程。顾名思义,镀金银线是在银外面电镀一层金,以下是镀金银线简单的生产工艺流程图:
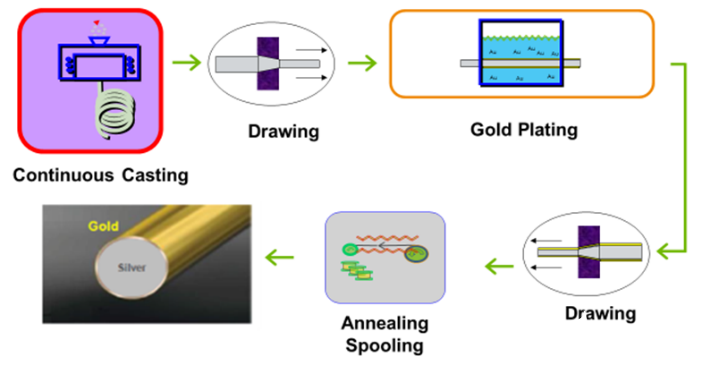
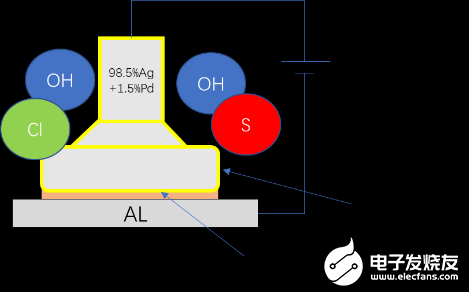
为何选择Au作为镀层材料?众所周知,金具有非常出色的抗氧化、抗腐蚀的特性,并与很多材料都有着良好的结合效果。因此,电镀一层金,对里面的银起到了很好的保护作用,从而提升了银线的抗硫化和抗腐蚀能力,也改善了银离子迁移的问题,提高了可靠性。
但是,由于Au与Ag 的材料属性决定了它们之间易融合从而相互扩散形成固容体,影响Au的表面覆盖率。所以,提高Au在Ag表面的覆盖率对于此类镀金银线的可靠性尤为重要。为了解决这个问题,通常会在Au与Ag之间加入阻碍层以延缓Au扩散到Ag内部。

FAB抗氯离子腐蚀对比实验结果表明,与银合金线相比,镀金银线有着非常出色的抗氯离子腐蚀的性能,这是因为FAB表面Au包覆性非常好。为何会有如此好的包覆性?这也是得益于阻碍层起到了作用,减少了Au向融化后的银球里扩散。另外,电镀时特殊的添加物会使Au 具有良好的表面张力及润湿性,在FAB 形成时会更多的Au流下来覆盖FAB。
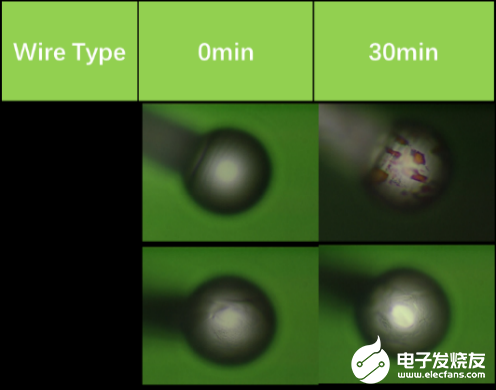
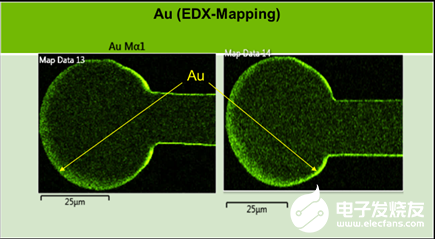
在FAB形成时,除金线外材料都需要惰性气体进行保护,从而对设备提出了更高的要求。但实验结果显示,镀金银线加了保护气后FAB反而会变差,这是由于气体破坏了Au Flow的流动,使Au 分布变差,所以,这款镀金银线的键合工艺无需保护气体,真正实现了Gas Free,降低了对设备的要求。

第一焊点与金线进行对比,球形很圆,特别适合小焊盘产品的使用;但由于镀金银线硬度会略高于金线,所以,在铝飞溅控制方面会略逊色于金线。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。举报投诉

个kile,但是安装后总感觉什么都没有,模板也找不到,完全不会用,球大神给讲解下……还有,Visual Studio的
,用于保证电化学检测器在断电的情况下两端电位不会偏差太大。附件为MMBFJ176规格书,望大神回复下,谢谢!
个非常挑剔的程序是 PET 的 INVADERS;我用它来进行快速测试)。注意:适配器将作为所有 ROM 芯片的直接
,因为不建议将其用于新设计(已过时)。为了最大限度地减少工作量,我们希望减少对 28 引脚 SOIC 封装的替换和简单的代码更改
贺利氏电子-宋建波 摘要: 半导体封装技术总体上可以分为两大类: (1) Wire Bonding 引线) Non-Wire Bonding 非键合工艺,如FC、Clip bond等封装技术。据相关数据统计,使用引线键合这种传统封装工艺的器件仍占据近70%的出货量。虽然近些年来以WLCSP为代表的先进封装技术发展迅速,但传统的封装工艺不会被完全淘汰,两者会长期共存发展。 谈到半导体封装就不得不提到其重要的封装材料—键合线。目前市场上的键合线根据材质分为几大类:金、银、
上一篇: 围绕核心技术进行工艺升级钧崴电子IPO上市扩大行业
下一篇: 电镀废水处理设备
 中文
中文  ENGLISH
ENGLISH 
